三光機s350;針對半導體先進封裝晶圓切割前後Die表面缺陷、切割道缺陷及RDL缺陷檢測
業內的 AI 2.0 檢測算法軟件簡單易用,集成自動編程功能
設備可檢測碰線、塌絲、甩絲、斷絲、漏焊、重焊、焊線高度、線線距離、沾污、劃傷、異物、偏移、轉角、翹片、有無、貼錯芯片、崩邊、崩角、多膠、少膠、爬膠高度……
晶圓表面臟污,殘膠,劃痕,切割道缺陷以及RDL缺陷檢測
- 支持明場、暗場、Photolumination、透射多種照明方式
- 業內的 AI 2.0 檢測算法
整面晶圓 Bump 高度及共面性量測
- 高速、的 Bump 高度量測係統
三光檢驗方法在電子芯片質量控制中扮演著至關重要的角色。通過這種檢驗方法,生產商可以在早期階段發現並解決潛在的質量問題,從而提高產品的良率和可靠性。同時,這也有助於減少因芯片質量問題而導致的設備故障和性能下降,保障消費者的利益。
總之,三光檢驗方法是電子芯片生產過程中不可或缺的一環。通過嚴格執行這一檢驗流程,我們可以確保電子芯片的質量和性能達到行業標準,為現代電子設備的穩定運行提供有力保障。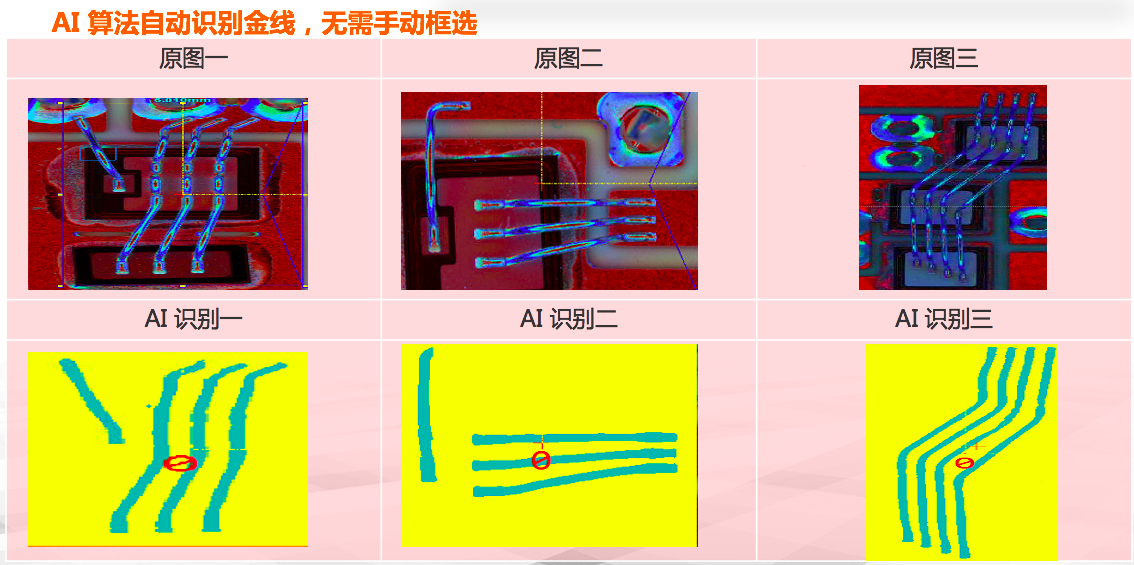
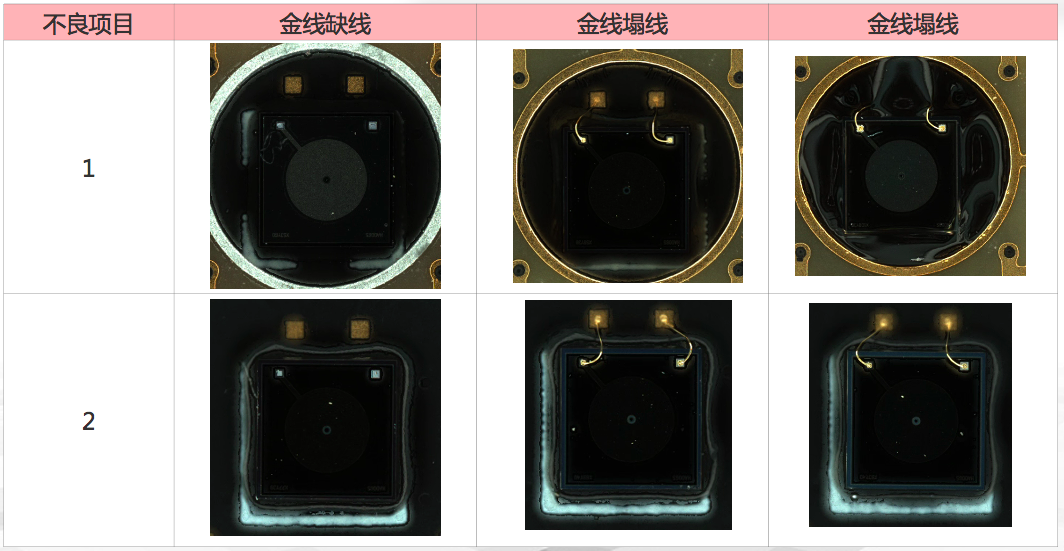
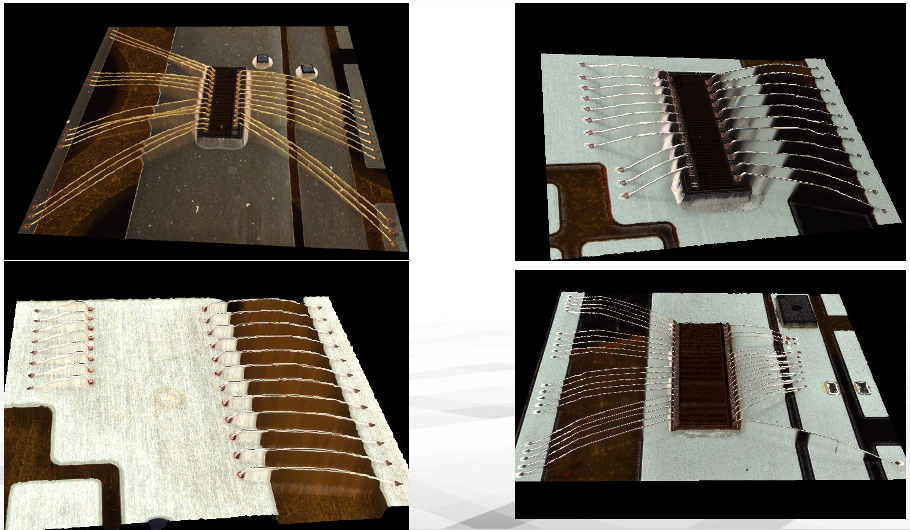
設備規格